⚫案例公司简介
案例企业主要从事计算机、半导体集成电路、混合集成三大 专业的研制开发、批产配套、检测经营,是集计算机、半导 体集成电路和混合集成科研生产为一体的大型专业研究所, 是中国航天微电子和计算机的先驱和主力。其承担了国家多 个重点工程及集成电路、混合集成产品配套任务,创造了中 国计算机和集成电路发展史上的“39 个第一”,并成功参加了 以载人航天工程、探月工程等为代表的大批国家重点工程发 射任务,为中国航天事业的崛起与腾飞做出了重要贡献。
⚫ 挑战和需求
业内以往对于温循条件下焊点的应力应变的研究,多是基于 温循结束后的应变分析或者多个温循条件下的应变积累,而 实际器件在整机温循试验中一般处于加电状态,器件自身功 耗会产生大量的热量,进而直接影响结构热应力结果,然而 目前行业内相关的研究较少,且物理实验成本极高,因此, 借助仿真手段开展瞬态热分析下的热力耦合研究非常必要。 771 所选取典型的 BGA 封装器件,考虑器件功率的影响,研 究焊点在温循条件下瞬态热力耦合力学行为。 研发人员希望仿真工具能够实现:解决温度循环载荷作用导 致封装器件失效问题,通过仿真软件模拟封装器件的失效过 程,得到器件的工作寿命;解决电、热、力,以及多物理场 耦合的仿真问题。此外,他们希望初学者也能够快速了解软 件进而开展仿真工作,同时希望软件提供商能够协助解决仿 真操作中遇到的问题。
⚫ 解决方案
Ansys 多物理场耦合功能,实现了 BGA 封装器件在瞬态热循 环条件下的热力耦合研究。1 在
Ansys Icepak 中进行典型 BGA 封装器件的瞬态热仿真 分析,得出封装器件的瞬态温度变化。2将瞬态温度值导入至
Ansys Mechanical 中完成器件热应 力分析,研究其焊点处所受应力随时间变化的规律。3 在全模型的基础上,采用 Ansys Mechanical 的子模型法 对关键焊点进行细化建模,分析结果。
⚫ 相关 Ansys 软件/解决方案 :Ansys Icepak, Ansys Mechanical
⚫ 最终成果
工程师将瞬态热循环条件下的热力耦合仿真分析结果作为可 靠性评估的参考,判断产品是否能正常工作。Ansys 仿真技 术的应用助力缩减产品生产周期,节约实验测试成本,减少 原材料的消耗,为降低相关领域产品的风险、保障产品质量 打下基础。 “Ansys 软件在我们的工程应用中扮演着非常重要的角色。 Ansys Icepak 软件帮助实现了温循条件的精确模拟,得到封装 器件的温度变化;Ansys Mechanical 软件实现了器件热应力分 析和焊点的循环寿命,大大节约了产品可靠性的测试时间。” ——师航波,中国航天科技集团公司第九研究院第七七一研 究所,助理工程师
访问Ansys官方网站
https://www.ansys.com/zh-cn/ 获取更多信息!
 如果您对此感兴趣,欢迎问问展商吧!
如果您对此感兴趣,欢迎问问展商吧!

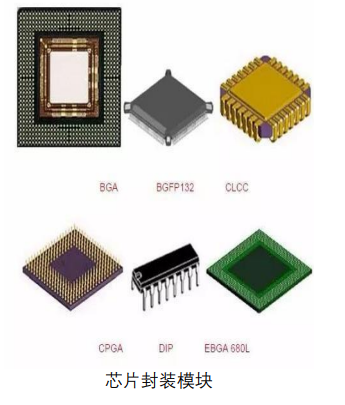
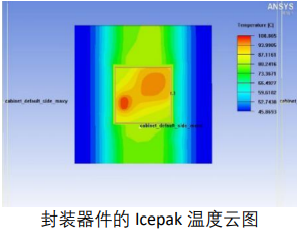
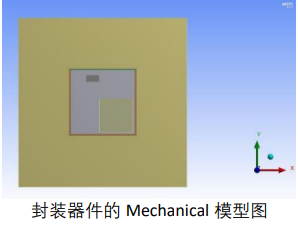


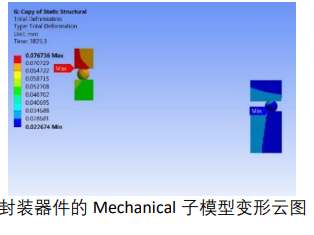
 如果您对此感兴趣,欢迎问问展商吧!
如果您对此感兴趣,欢迎问问展商吧!
 如果您对此感兴趣,欢迎问问展商吧!
如果您对此感兴趣,欢迎问问展商吧!